
昂筠國際相關影片
濺鍍/材料知識
超薄銅箔與mSAP製程對於細線路及製造IC載板的優勢
UTF超薄銅箔介紹:
超薄銅箔通常是指低於9um厚度的銅箔,英文全名是Ultra Thin Copper Foil. 這種極薄銅箔由於過於輕薄,因此通常會附加一層約15-18um較厚的載體銅箔來增加其支撐性。目前主要用於高階PCB印刷電路板製造,包括 IC 載板、Coreless 基板等。
昂筠供應的附載體超薄銅箔主要是由18um載體銅箔與3μm/5μm超薄銅箔所組成,中間有一層剝離層(Releasing Layer)。昂筠超薄載板銅箔容易撕離,具有極低的表面粗糙度(Rz<2um)、產品蝕刻性佳等特性。
mSAP改良型半加層法可改善PCB測蝕造成的良率問題並節省製造成本:
“mSAP (Modified Semi-Additive Process)是PCB製程中“改良型半加層法”的英文縮寫,指BT板材的內層core核心板。改良式半加成法可改善傳統PCB減成法的問題 : 包括在蝕刻時容易造成側蝕問題、進而影響線寬/線距小於50um時產品良率過低狀況。
另外mSAP也是精細線路製作時節省成本的替代方案 : SAP半加成法是PCB極細線路製作時採用的製程,需使用昂貴的ABF膜材。而採用mSAP工藝時利用2-3um超薄銅皮做為起步銅,可取代SAP製程中的化銅層,去模擬做出細線路。使用的材料不同,可降低生產成本。
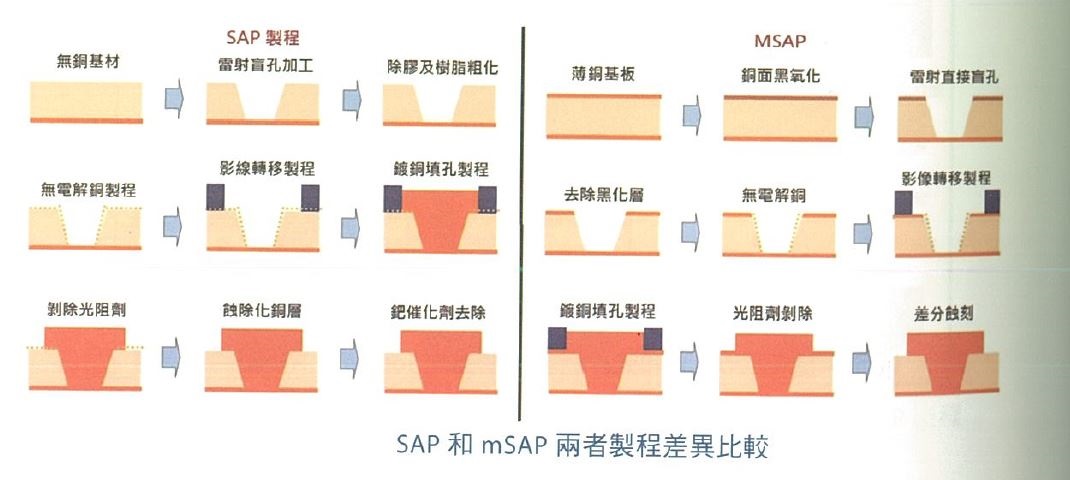
mSAP製程的特點是圖形在形成過程主要依靠電鍍、閃蝕處理,而在閃蝕過程所蝕刻化學銅層相當的薄,因此,蝕刻耗時非常短,不易產生電子電路線路側向蝕刻問題。
採用mSAP製程更適合細線路的設計與製造,可以將線寬/線距縮短到30/30μm,大幅提高元器件集成度並減小PCB板的物理空間,從而將更大空間留給電池。目前廣泛應用在類載板、IC載板、Coreless 基板的製造上。
mSAP改良式半加成法優勢:
超薄銅箔通常是指低於9um厚度的銅箔,英文全名是Ultra Thin Copper Foil. 這種極薄銅箔由於過於輕薄,因此通常會附加一層約15-18um較厚的載體銅箔來增加其支撐性。目前主要用於高階PCB印刷電路板製造,包括 IC 載板、Coreless 基板等。
昂筠供應的附載體超薄銅箔主要是由18um載體銅箔與3μm/5μm超薄銅箔所組成,中間有一層剝離層(Releasing Layer)。昂筠超薄載板銅箔容易撕離,具有極低的表面粗糙度(Rz<2um)、產品蝕刻性佳等特性。
mSAP改良型半加層法可改善PCB測蝕造成的良率問題並節省製造成本:
“mSAP (Modified Semi-Additive Process)是PCB製程中“改良型半加層法”的英文縮寫,指BT板材的內層core核心板。改良式半加成法可改善傳統PCB減成法的問題 : 包括在蝕刻時容易造成側蝕問題、進而影響線寬/線距小於50um時產品良率過低狀況。
另外mSAP也是精細線路製作時節省成本的替代方案 : SAP半加成法是PCB極細線路製作時採用的製程,需使用昂貴的ABF膜材。而採用mSAP工藝時利用2-3um超薄銅皮做為起步銅,可取代SAP製程中的化銅層,去模擬做出細線路。使用的材料不同,可降低生產成本。
mSAP製程的特點是圖形在形成過程主要依靠電鍍、閃蝕處理,而在閃蝕過程所蝕刻化學銅層相當的薄,因此,蝕刻耗時非常短,不易產生電子電路線路側向蝕刻問題。
採用mSAP製程更適合細線路的設計與製造,可以將線寬/線距縮短到30/30μm,大幅提高元器件集成度並減小PCB板的物理空間,從而將更大空間留給電池。目前廣泛應用在類載板、IC載板、Coreless 基板的製造上。
mSAP改良式半加成法優勢:
- 作為小型BGA載板廠節省成本的替代方案
- 適合精密線路的生產,可讓導電路徑佈局更密集,進而節省空間
- 縮小PCB電路板的體積,騰出空間給其他電子零件包括電池、感測器、相機等使用
- 訊號路徑短,改善印刷電路板上的訊號傳輸
- 加速電子產品微型化發展